深度解析GJB7400-2011塑封集成電路鑒定(dìng)程序
作者:
技術遊俠
編輯:
草莓视频网站儀器
來源:
技術遊俠
發布日(rì)期: 2019.12.20
國內(nèi)塑封半導體(tǐ)集成電(diàn)路鑒定檢驗主要依據(jù)GJB7400-2011《合格製造廠認(rèn)證用半導體集成電路通用規範》進行。標準包括了器件應滿足的質量和可靠性保證要求,並規定了相應的產品質量保證等(děng)級(V級、Q級、T級、N級)。
GJB7400-2011中4.4條鑒定檢驗規定,應按附錄B中B.2.4.2和B.2.4.3的規(guī)定進(jìn)行(但(dàn)附錄B中並沒有B.2.4.2和(hé)B.2.4.3),器件並應至少滿(mǎn)足本規(guī)範A、B、C、D和E組(適用時)的試驗要求。但目前國內大多數單位在按照標準中的D4分組進行檢驗時(表1所示),預處理條件(表貼塑封器件)及熱衝擊、溫度循環試(shì)驗樣品疊(dié)加及降低強加速穩態(tài)濕熱條件等問題日益突(tū)出。

1、表貼塑封器件的預處理
表麵貼裝(zhuāng)塑封器件屬(shǔ)於非氣(qì)密封器(qì)件,外部環境中的潮氣易滲透進封裝內部,組裝過程(chéng)中的焊(hàn)接高溫將導致(zhì)器件內部界麵(miàn)產生分(fèn)層,甚至爆炸開裂。所以,表貼塑封器件比通孔安(ān)裝的塑封器件更容易發生失效(xiào),進行預處理十分必要。但預處理的試驗條件(jiàn)卻沒有對應的國軍標,也沒有國標或是行標,隻是簡單的一句話“按器件詳細規範的規定”。導致(zhì)一(yī)些單位在(zài)進行(háng)預處理時往往隻按GJB548B-2005方法1008進行穩定(dìng)性烘焙。
查閱NASA在2003年(nián)發布的(de)頒布(bù)PEM-INST-001《塑封微電(diàn)路選用、篩選和鑒定指南》可知,塑封集成電路預(yù)處理試驗時(shí)按照JESD22-A113-F《可靠性測試前非密封表麵貼(tiē)裝器件預處理》進(jìn)行,該(gāi)標準(zhǔn)采用了溫度循環、穩定烘焙及回流焊三種組合方式進行(háng)預處理。
a)溫度循(xún)環,按照MIL-STD-883方法1010試驗條件為-40℃~60℃,5次;
b)穩定烘焙,對於濕度敏感度2a-5a級的器件(JEDEC-STD-033C)預處理為(厚度≤1.4mm,125℃下烘烤8h~28h;厚度≤2.5mm,125℃下烘(hōng)烤(kǎo)23h~24h;厚度≤4.0mm,125℃烘烤48小時)。
c)回流焊,回流曲線按照JEDEC-STD-020E.1進行,根據不同潮(cháo)濕敏感度等級(1級(jí)~6級(jí))的器件對應允許暴露的(de)時間(離袋長時間),選擇不同條件的吸潮試驗(如圖1所示),大多數單位選擇條(tiáo)件30℃/60%RH、192h。當從高低溫濕熱試驗箱中取出樣品後至少放置15min,並在4h內進行3次回流焊(各區間溫度見圖2~圖3所示)。如果樣品取出高低溫濕熱試驗箱和初始回流焊之(zhī)間的等待時間沒有達到(dào)要求(qiú),需重新進行穩定烘培及吸潮,回流焊之間(jiān)的間隔時(shí)間應在(zài)5min~60min,並充分(fèn)進(jìn)行有效降溫,避免(miǎn)影(yǐng)響後續的回流焊。

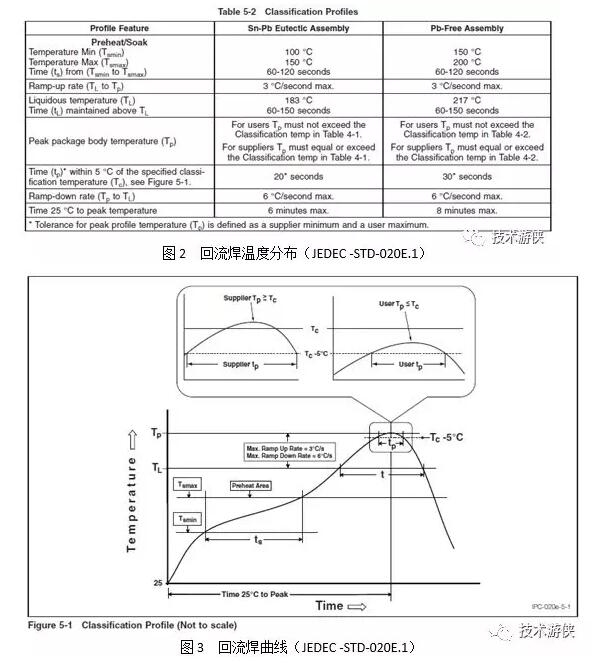
回流焊(hàn)三次循環的過程:第(dì)1次循環,模擬器件在(zài)雙層板兩次組裝中的次回流焊過程;第2次循環(huán),模擬器件在雙層板兩次組(zǔ)裝中的第二(èr)次回流焊過程;第3次循環,模擬器件返工的回流過程。
全(quán)部預(yù)處理結束後(hòu)用40倍光學放大鏡檢查外部是否有(yǒu)裂紋。
2、D4a)分組試驗樣品的疊加(jiā)
目前國產塑封器件按N級進行考核,大(dà)多數通過不了D4a)組(zǔ)試驗(yàn),主要原因是GJB7400-2011表6中的4a)組冷熱衝擊和溫度循環試驗的樣品(pǐn)(22隻)是疊加進行,即做完冷熱衝擊試驗後的樣品繼續進行溫度循(xún)環試驗。
冷熱衝擊試驗主要考察塑封材料熱脹冷縮引起的交(jiāo)變(biàn)應力,試驗可能會造(zào)成(chéng)材料的開裂、接(jiē)觸不良、性能變化等現象,而
溫(wēn)度循環試驗主要是測定器(qì)件(jiàn)承受極端(duān)高溫和極端低溫的(de)能力,以及極端高(gāo)溫與極端低溫交替變化對器件的影響,當樣品經(jīng)受極端環境應力循環時,若塑封內部各材料的熱膨脹係數(shù)不匹配,缺陷部位就會受到應力而(ér)不斷擴大,從而產生熱(rè)疲勞失(shī)效開裂現象。
因此,試驗樣品的疊加對器件(jiàn)的封裝可(kě)靠(kào)性要求相(xiàng)對較高。同一組的樣(yàng)品在(zài)經曆冷熱衝擊100次150℃~-65℃後,再進行溫度循環(huán)1000次-65℃~150℃時,大多(duō)數產品會失效,進行(háng)S-CAM檢查時經(jīng)常會發現芯片與(yǔ)塑封料的大麵積分層。
針對上述(shù)情況,國內一些單位又(yòu)想通過GJB7400的N級(jí)鑒定,但按標準(zhǔn)又不能通過,所以隻能降(jiàng)低考核(hé)要求(所謂的N1級考核(hé)),采取試驗樣(yàng)品分組(即用不同樣品分別進行熱衝擊和溫(wēn)度循環)和降低試驗條件的方式(shì)通過4a)組考核,典型試(shì)驗條件見表2所示。
表2 塑封器件N1級 D4分組(4a、4b)試驗項目及條件

另外,樣品在進行高壓加速老化試驗(HAST)後,檢查外觀通常也會發現腐(fǔ)蝕,因為塑封料在交聯固化時會產生氯化鈉作為副產品(pǐn),如在封裝時(shí)沒有及時去除,那麽在強加速穩態濕熱試驗中極易暴露這一缺陷並發(fā)生腐蝕,尤其是(shì)塑封中的Al金屬腐蝕更為(wéi)明顯。所以,采取降低D4b)分組中高壓加(jiā)速老化試驗(HAST)的試驗條件,典(diǎn)型試(shì)驗條件見表3所示。
表(biǎo)3 塑封(fēng)器件N1級 D4分組(4c)HAST試(shì)驗條件

3、D4分組的聲學掃描顯微鏡(jìng)檢查判據要(yào)求(qiú)
在進行(háng)D4分組試驗前,需(xū)進行一次聲學掃描顯微鏡檢查,檢查並記錄引線框架(正麵與(yǔ)背麵)與模塑料之間、芯片(piàn)基(jī)座(zuò)(正麵和背麵)與模(mó)塑(sù)料直接的(de)分層。當進行熱衝擊與溫度循環試驗後,再進行聲學掃描顯微鏡檢查。檢測器件時,呈現任何下(xià)來缺陷的器件應判(pàn)不(bú)合格:與(yǔ)4組超聲檢測比較,引線框架和芯片基座分(fèn)層麵積變(biàn)化超過10%;芯片表麵、引出端引線鍵合區出現(xiàn)分層(céng);塑料出現空洞或(huò)裂紋符合GJB4027A-2006工作項目1103中2.4.4的規定。
D4分組的(de)聲掃判據相(xiàng)比GJB4027A-2006工作項目1103中2.4.4增加了(le)引線框架和芯片基座分層麵積變化率的要求,但對引腳從塑封完全剝離及連筋頂部分層(céng)超過其長度的1/2的這兩條判據未做要求。
另(lìng)外,需要留意GJB7400-2011塑封器件篩選程序中(表1B)的(de)聲學掃描顯微鏡檢查中的判據與鑒定(dìng)程序的差異(yì)。用於找出器件的芯片表麵及引出端焊(hàn)線鍵合區的嚴(yán)重缺陷(隻做頂(dǐng)視圖)。判據(jù)如下:
a)裂紋:塑料封裝內與(yǔ)鍵合引線交叉的(de)裂縫;從任一引線指至任(rèn)一內部(bù)特征(zhēng)物(引腳(jiǎo),芯片,芯片(piàn)粘接側翼(yì))的內部裂(liè)紋,其長度(dù)超過相應間距的1/2;任何延伸至封裝表麵的裂紋;
b)空(kōng)洞:跨越鍵合絲的模塑料的(de)任何空洞;芯片區內有任何模塑料內部(bù)的空洞,其他區域大於0.25mm;
c)分層:芯片(piàn)與模塑料間的任(rèn)何可測量的分層;引出端引(yǐn)線鍵合區的任何分層(céng);大於引腳內(nèi)部長度2/3的分層(céng)。
後,對於完成聲學掃(sǎo)描顯微鏡檢查(chá)後的樣品,建議按照標準PEM-INST-001,在125℃下烘烤1h,以便去除樣品吸附的水分。
參考標準:
PEM-INST-001、JEDEC-STD-033C、MIL-STD-883K、JESD22-A113-F、GJB7400-2011、GJB4027-2006、JEDEC-STD-020E.1
文章(zhāng)出(chū)自:技術遊俠
如有(yǒu)侵(qīn)權,刪
PRODUCT RECOMMENDATION產品推薦
-

-
01 恒溫恒濕試驗箱
是模擬產品(pǐn)在氣候環境溫濕組合條件下(高低溫操作與儲存、溫度循環、高溫高濕、低溫低濕(shī)、結露試驗...等),檢測產品本身的適應能力與特性是否改變的(de)測試設備。
查看詳情+
-

-
02 冷熱衝擊試(shì)驗箱
是用(yòng)來測試材(cái)料結構或複合材料,在瞬間下(xià)經極高溫及極低溫的連續環境下所能忍受的程度,借以(yǐ)在短時間內試驗其因熱脹冷縮(suō)所引起的化學變化(huà)或物理傷害。
查看詳情+
-

-
03 快速溫變試驗箱
是通過向待測品施加合理的環境應力和電應力,使得由不良元器件、零部(bù)件或工藝缺陷等(děng)引起的產品早期(qī)缺陷加速變成故障,並加以(yǐ)發(fā)現和排(pái)除(chú)的過程(chéng),是一個經濟有效的工程研究、製造改進手段。
查看詳情+
-

-
04 HAST試驗箱
用於評估非氣密性封裝IC器件、金(jīn)屬材料等在濕度環境下的可靠性。在溫(wēn)度(dù)/濕度/偏壓條件下應(yīng)用於加速濕氣的滲透,可通過外部(bù)保護材料(塑封(fēng)料或封口),或在外部保護材料與金屬(shǔ)傳導材料之間界麵(miàn)。
查看(kàn)詳情+
-

-
05 步入式恒溫恒濕試驗室
測試產品在不同溫度、濕度等氣候條(tiáo)件下的性(xìng)能和壽命。應用於(yú)國防工業、航天工業、自動化零組件、汽車部件、電子電器件(jiàn)以及塑膠、化工、製藥工業相關產品的耐熱、耐寒測試。
查看詳情+