又稱MRT,是用來模擬芯片從(cóng)運輸到(dào)上板的整個流程(圖5-1)。

T&H的條件分為6級,用來模擬芯片在生產過程中環境溫度和(hé)濕度,通常(cháng)我們使用Level3 (表5-1)。

IR Reflow的條件是在在240度的烘箱內過(guò)三遍,用(yòng)來模擬芯片在做SMD時的狀況(圖5-2)。

SAM也叫SAT,是用超聲波來做斷(duàn)層掃描的一種檢測方法,利用超聲波在不同表麵會造成反射的原理(圖5-3),可(kě)以檢測到材料中的不同材料之間斷層等等,在BGA封(fēng)裝(zhuāng)中可以檢測銀(yín)漿(jiāng)空洞(EpoxyVoid),環氧樹脂(zhī)空洞(MoldVoid),樹(shù)脂與芯片之(zhī)間(jiān)的斷(duàn)層( Delamination)等等。

1)A SCAN:由於材(cái)料之間會發生反(fǎn)射,將示波器的到反射的波形來和正常波形進行對比(bǐ),來判斷在(zài)什麽(me)位置發(fā)生問題(圖5-4)。

3)T SCAN:與A SCAN相反,T SCAN利用另一個探頭接受穿透後的超聲波(bō),轉化(huà)成電信號來(lái)分析(圖5-5)。

C SCAN是精確的空洞(dòng),斷層等缺陷的分(fèn)析方法。

耐久性實驗既是芯片的(de)老化試驗,浴盆曲線代表了半導體器件的失效分(fèn)布和時間的關係,48小時內的前期失效是屬於潛在的質量問題,在48小(xiǎo)時到106小時內是失效率(lǜ)相對較低的,106 小時後(hòu)屬於老化(huà)失(shī)效(圖5-7)。所以,根據芯片的不同用途,耐久性實驗也分為不同的級別,如下圖:

對於不同的芯片(piàn)封裝結構(gòu),用途等考量,試驗者會選取具有針對(duì)性的可靠性測試的項目,我們此次隻是金線更換銅線的線材(cái)更換試驗,所(suǒ)以根據查閱公司規範文件,需要做的可靠性測試是MRT,TC和HTS,可選項HAST,如下表5-1:

3) 1000 Cycle
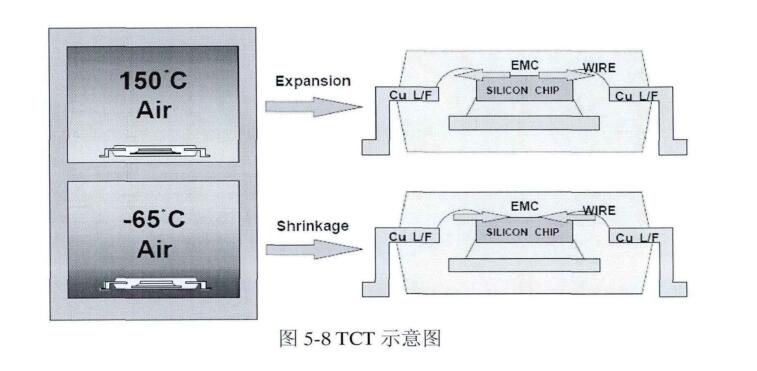
1) Open 的失效來源於EMC與(yǔ)芯(xīn)片表麵分層導(dǎo)致的焊球脫離或焊線斷裂(圖5-9)。

2) Short 的失效(xiào)來源於Chip Crack (圖5-10)。

半導體器件(jiàn)持續運行的(de)問題很高,高溫會加速一些(xiē)材料間的分子級別的(de)擴散,主要集中在焊(hàn)球和焊(hàn)盤(pán)之間,由於擴散速度不同的加速,導致(zhì)產(chǎn)生Kirkendall空洞,嚴重者會造成焊點分離(圖5-11)。
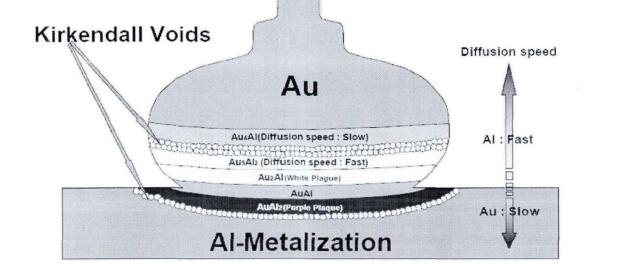

1) Open 主(zhǔ)要是潮氣對焊盤的腐蝕,造成了虛焊(圖5-12)。

2) Short 主要是由於潮氣的滲入,造成了EMC內部有漏電(圖5-13)。

芯片(piàn)測試數量的選取按照(zhào)客戶(hù)對於芯片(piàn)可靠性等級的要求來(lái)確(què)定(dìng),通常是SQB評估(Qual Level B),所以必須設(shè)置3個實驗(yàn)組,每個實驗組的數量是22+3x77=253 (表(biǎo)5-2)。

MRT的條件如下表5-3:
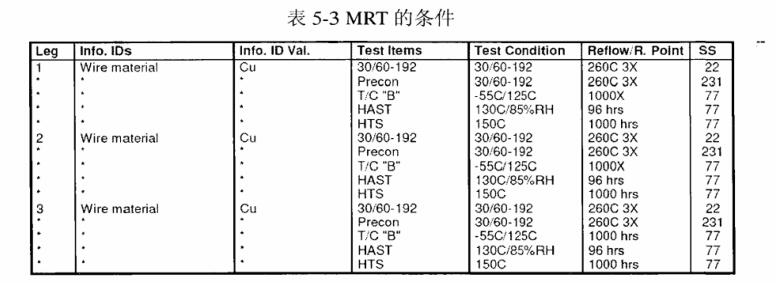
Long Term的條件如(rú)下表5-4:

備(bèi)案號:粵ICP備11018191號
谘詢熱(rè)線:400-088-3892 技術支持:草莓视频网站儀器 百度統計400電話