芯片(piàn)可(kě)靠性測試之(zhī)HAST高壓加速老(lǎo)化測試
作(zuò)者:
salmon範
編輯:
草莓视频网站(kǎi)儀器
來源:
www.tuyatang.com
發布日期: 2020.09.27
開發一款芯片基本(běn)的(de)環節就是——設計>流片>封裝>測試,芯(xīn)片成本構成一般為人力成本20%,流片40%,封(fēng)裝35%,測試5%。(對於(yú)先進工藝,流(liú)片(piàn)成本可能超過60%)。

測試隻占芯(xīn)片各個環節的5%,看似是“便宜”的,在每家公司都喊著(zhe)“降低成本”的時候,人力成本不斷的攀升,晶(jīng)圓廠和封(fēng)裝廠都在乙方市場(chǎng)中叱吒風雲,似乎隻有測試這一環節沒有那麽難(nán)啃,於是“降(jiàng)低成本”的算盤就落在了測試的(de)頭上了。
但仔細算算,就算測試省了50%,總成本也隻是省了2.5%,但(dàn)是測試是產品質(zhì)量的(de)後(hòu)一關,若(ruò)沒有良好的測試,那麽產品(pǐn)PPM(百萬失效率(lǜ))過高,被退回(huí)或賠償都(dōu)遠遠不隻這5%的成本。
芯片需要做什麽測試?
芯片的測試主要分為三大類:芯片(piàn)功能測試、性能測(cè)試、可靠性測試。這三(sān)大測試缺一不可。

其中,芯片的可靠性測試(shì)可以測試芯片是否會被冬天裏的(de)靜電弄壞,在雷雨天、三伏(fú)天、風雪天等複雜環境中能否正(zhèng)常工作,以及新開發(fā)的芯片能使用一個月、一年還是十年的使用(yòng)壽命等(děng)等。要知道(dào)到這些(xiē)問題,都需要通過可靠性測試進行評估。
而芯片(piàn)可靠性測試中,不可或(huò)缺的是HAST測試!
HAST高壓加速老化測(cè)試【Highly Accelerated Stress Test】可檢測芯片封裝的耐濕(shī)能力,待測產品被置於嚴苛(kē)的溫度、濕度及壓力下測試,濕氣(qì)是否會沿者膠體或膠體與導線架之接口滲入封裝體從而損壞芯片。
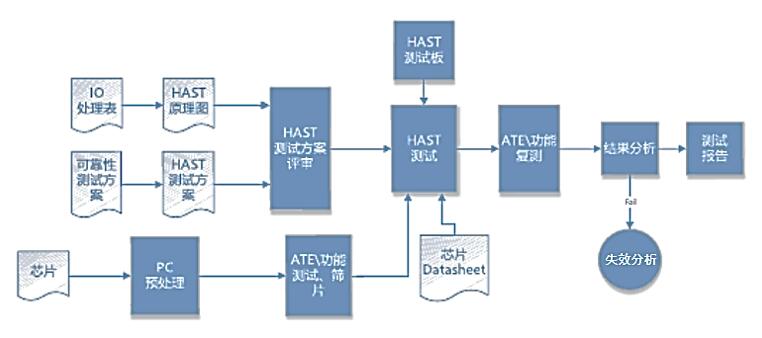
JESD22-A118試驗規範與(yǔ)條件(HAST無偏壓(yā)試驗):
用來(lái)評價(jià)器件在潮濕環(huán)境中的可靠性,即施加(jiā)嚴酷的溫度、濕度及提(tí)高水汽壓力通(tōng)過外部保護材料(包封料或密封(fēng)料)或沿著外部保(bǎo)護材料和金屬導體介麵(miàn)的滲透,其失效(xiào)機製與[85℃/85%RH]高溫高濕穩態溫度壽命試驗(JESD22-A101-B)相(xiàng)同,該試(shì)驗過程(chéng)未施加偏壓(yā)以確保失效機製不被偏壓所掩蓋。需要注意的是,由於吸收的水汽會降低大多數聚合物材料的玻璃化轉變速度,當溫度(dù)高於(yú)玻璃化轉變溫度時,可能會出現(xiàn)非(fēi)真實的失效模式。
常用測試條件:110℃/85%RH——264小時。

常(cháng)見的故障原因:
1、爆米花效(xiào)應
2、動金屬化區域腐蝕造成之斷路
3、封裝體引腳間因汙染造成之短路
注(zhù):爆米花效應(Popcorm Effect)特指因封裝產生裂紋而導致芯片報廢的現象,這種現象發(fā)生時,常伴有(yǒu)爆米花般的聲響,故而得名。