MEMS封裝可靠性測試規範
作者:
網絡
編輯:
瑞(ruì)凱儀器
來源:
網絡
發布日期: 2020.08.31
1.引言
1.1MEMS概念
微光機電係(xì)統(Micro ElectroMechanical Systems-——MEMS),以下簡稱MEMS。MEMS是融合了矽微加工、LIGA (光刻、電鑄和塑鑄)和精密機械加工等多種微加工技術,並應(yīng)用(yòng)現代信息(xī)技術構成的微(wēi)型係統(tǒng)。它在微電子技術的基礎上發展起來的,但又區別於微電子技術(shù)。它包括感知外(wài)界信息(力、熱、光、磁(cí)、電、聲等)的傳(chuán)感器(qì)和控製對象的執行器,以及進行信號處理和控製的電路。MEMS器件和傳統的機器相比(bǐ),具有(yǒu)體積小、重量輕、耗能低、溫升小、工作速(sù)度快、成本低、功能強、性能好等特點。
1.2MEMS封裝可靠性測(cè)試規範所含範圍
本(běn)可靠性測試規範涉(shè)及到在MEMS封裝工藝中的貼片(包括倒(dǎo)裝焊、載帶自動焊)、引線(xiàn)鍵合、封蓋等幾個重要工(gōng)藝(yì)的可靠性測試。每步工藝(yì)的測試項目可根據具體器件要求(qiú)選(xuǎn)用。
2.貼(tiē)片工藝測試
2.1貼(tiē)片工藝測試要求
貼片工(gōng)藝是(shì)將芯(xīn)片用膠接或焊(hàn)接的方式連接到基座上的工藝過程。膠接(jiē)或(huò)焊(hàn)接的質量要受到加工環境(jìng)與工作環境的影(yǐng)響,因此要對膠(jiāo)接(jiē)或焊接的質量與可靠性(xìng)進行測試。膠接或焊接處表麵應均勻連接,無(wú)氣孔,不起(qǐ)皮,無裂紋,內部無(wú)空洞,並能承受一定的疲勞強度。
在熱循(xún)環、熱衝擊(jī)、機械衝擊、振動、恒定(dìng)加速度等(děng)環境工作時,芯片與基座應連接牢固,不能產生過大的熱應力。芯片(piàn)與基座(zuò)無裂紋(wén)。
2.1貼片工藝測試項目

3.1引線鍵合工藝測試要求
引線鍵合工(gōng)藝是用金或(huò)鋁線將芯片.上的信號引(yǐn)出到封(fēng)裝外殼的管腳上的工藝過程。引線和兩焊點的質量要受到加工環(huán)境與工作環境的影響,因此要對引線鍵合的質量與可靠性進行測試(shì)。要求用50倍(bèi)的放(fàng)大鏡(jìng)進行外觀檢查,主要檢查兩鍵合點的形狀(zhuàng)、在焊盤上的位置(zhì)、鍵(jiàn)合點引線與焊盤的粘(zhān)附情況、鍵合點根部引線的變形情況和鍵合點尾(wěi)絲的長度等是否符合規定。在熱循環、熱衝擊、機械衝擊、振動、恒定加速度等環境(jìng)工作時,引線應牢固、鍵合點具有一定的強(qiáng)度。
3.2引線鍵合工藝測試項目
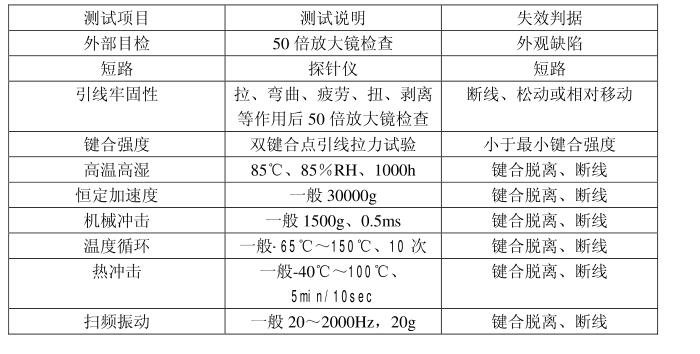
4.1封蓋工藝測(cè)試要求(qiú)
在貼片和引線鍵合工藝之後就(jiù)是封蓋工藝。由於外殼與蓋板熱膨脹係數不一致 導致在封蓋過程中產生熱應(yīng)力,在熱循環、熱衝擊、機械衝擊、振動、恒定加速度(dù)等環境(jìng)工作(zuò)時很容易產生機械和熱應力疲勞,出現裂紋,同時發生泄漏現象。因此要求對蓋板的微小翹曲進行測試和進行氣密(mì)性測試。密封腔中水汽含量過高會(huì)造(zào)成(chéng)金屬材料的腐蝕,要求進行水汽含量的測(cè)試。
4.2封蓋工藝測試項目

5.1MEMS封裝可靠性篩選試驗要求
MEMS封裝的失效率與時間的關係可分為三個階段:早期失效(xiào)階段、偶然失(shī)效階段和耗損階段。一(yī)些具有潛在缺陷的早期失效產品,必須通過篩選試驗來剔除(chú)掉。一般是在MEMS封(fēng)裝上施加一定的應力,施加(jiā)應力的大小(xiǎo)應有利於失效MEMS封裝的劣化,而不會損傷(shāng)合格MEMS封裝。
5.2MEMS封裝可靠性篩選試驗項目
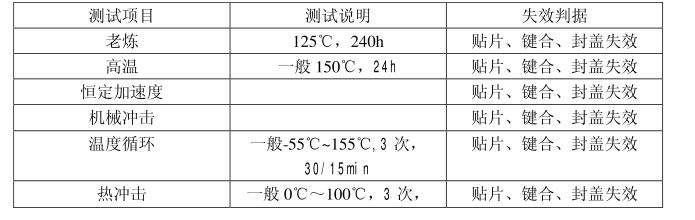

6.1MEMS封裝可(kě)靠性壽命試(shì)驗要求
壽命試驗是指(zhǐ)評價分析MEMS封(fēng)裝壽命特征量的試驗(yàn)。它(tā)是在試(shì)驗室裏,模擬實際工(gōng)作狀態或儲存狀態,投入一定量的樣品進行試驗(yàn),記錄樣品數量、試驗(yàn)條件、失效個數、失效時間等,進行統計.分析,從而評估MEMS封(fēng)裝的可靠性特(tè)征值。一般采用(yòng)加大應力來促使(shǐ)樣品在短期內失效的加速壽命試驗方(fāng)法。但不應改變受試樣品的失效分布。
6.2MEMS封(fēng)裝可靠性壽命試驗項目