技術分析:溫度循環測試對芯片燒(shāo)結性(xìng)能的影響
作者:
網絡
編輯:
草莓视频网站儀器
來源(yuán):
網(wǎng)絡
發布日期: 2020.06.17
引言
半導體器件在貯存、運輸和使用過程中時刻要遇到溫度環境,溫度環境應力對元(yuán)器件性能的影響時刻存在(zài)。例如,高溫時導致半導體器件發生軟化、效能(néng)降低、特性改變、潛在破壞、氧化、熔化及升華、物理膨脹等現象;低溫使材料發生龜裂、脆化、可動部卡死、特性改變等現(xiàn)象;溫度衝擊造成反複熱脹冷(lěng)縮,產生機械應力等。
溫(wēn)度環境應力對半導體器件作用更加突出和複雜,導致元器件出現各種形式的失效,嚴重影響武器裝備的可(kě)靠性和安全(quán)性。本文通過溫度循環試(shì)驗(yàn)對一種封裝結構的半導體器件封裝進行了試驗,測定了該封裝結構的退化情況,測試結果(guǒ)表明該封(fēng)裝對溫度有較好的耐受性。
1、實驗
1.1設備
溫(wēn)度循環試驗箱;X射線焊點檢測儀;推拉力剪切力測試。
1.2試驗方法及判定標準
溫(wēn)度循環按(àn)CJB 548B方法1010.1,條件C (-65℃~150℃ )的要求進(jìn)行進行; X光檢測按CJB 548B方法2012.1的要求進行;鍵合(hé)拉力試驗按GJB 548B方(fāng)法(fǎ)2011.1條件D的要求進行;芯(xīn)片剪切強度按(àn)CJB 548B方法2019.2的要求進行。
1.3樣品結構及試驗安排
選擇一種陶瓷(cí)封裝電路,該電路采用芯片背金燒結工藝,內引(yǐn)線采用為矽鋁絲超聲楔(xiē)形焊。試驗使用樣品100隻,分為10組(zǔ),每組10電路。溫度循環共進行1000次,每100次抽取1組進行(háng)芯片剪切(qiē)力、鍵(jiàn)合拉力、X光檢查測(cè)試。
1.4樣品的預先(xiān)處理
在進行該試驗前,該電路按照產品詳細規範的要(yào)求進行了(le)篩選,對早期失效的電路進行了淘汰。在篩選合格電路中選(xuǎn)取100隻芯片(piàn)燒結空洞率小於15%的產品作(zuò)為本次試驗的樣品。
2、結果與討論
2.1芯片剪切強(qiáng)度結果(guǒ)
該電路共進行了溫度循環試驗1000次,每100次溫度循環試驗後對電路進(jìn)行鍵合(hé)拉力測(cè)試,測試電路為試驗電路中隨機抽取的10隻(zhī)電路(lù),對10電路的全部芯片剪切力試驗,對比試驗數據,得到溫度循環試驗過程後芯片(piàn)剪(jiǎn)切強度的變化規(guī)律,表I為試驗後拉力測試的(de)數據統計。
芯片(piàn)通過燒結材(cái)料與管(guǎn)殼進行固(gù)定。芯片、管殼、粘接材料間具有不同的膨脹係數,在受熱或(huò)者遇冷的情況下會不同程度的發生形態上的變化。溫度循環試驗將(jiāng)不斷變化的溫度應力施加到產品上,使(shǐ)芯片、管殼、粘(zhān)接材料不斷產生形態上的變化,從而在各接觸麵間產生機(jī)械應力(lì)。當(dāng)使(shǐ)用的芯片、管殼、粘接(jiē)材料的膨脹係數非常接(jiē)近時,所產生(shēng)的機械應力較(jiào)小,粘接性(xìng)能退化慢,反之會造成粘接(jiē)性能(néng)的(de)急劇退化。
從圖1中的統計數據可以看到(dào),各階段試驗後(hòu)芯片剪切(qiē)測試值均滿足GJB 548B的要求,芯片剪切強度在(zài)有限區間內上下波動。但在經過700次溫度循環試驗後,雖(suī)然芯片剪切強度均(jun1)滿足GJB 548B的要求,但測試值全部處於(yú)區間的下半(bàn)部,而不(bú)是以,上下波動的形式出現。該測試結果(guǒ)反映出,芯片粘接性能可(kě)能在700次溫度循環試驗後逐步出現了退化現象,雖然退化的(de)情況並不明(míng)顯。

2.2內引線拉力強度結果(guǒ)
該電路共(gòng)進行了溫度循環試驗1000次,每100次溫度循環試驗後對電路進行鍵合拉力測試,測試電路為試驗電路中隨機抽取(qǔ)的10隻電路(lù),對10電路的全部引線進行試驗,對比試驗數據,得到溫度循環試驗過程中引線拉力強度的變化規律,表2為試驗後拉力測試的(de)數據統計(jì)。
溫度循環核試驗對內引線的作用原理同(tóng)樣是基於材料的熱脹冷縮特性而產生的機械應力作用。從圖2可以看到,雖然在(zài)1000次試驗過程中的引線拉力測試值均滿足CJB
548B的合格判(pàn)別(bié)要求,但引線拉力測(cè)試值在500次溫度循環中出現了快速的退化,而後直到1000次溫度循(xún)環(huán)試驗中的測試值處於(yú)一個相對比較溫度的範圍,引線拉力測試(shì)值(zhí)沒有出現持續的退化。


2.3芯片粘接空洞結果
該(gāi)電路共進(jìn)行了溫度循環試驗100次,每100次溫度循環試驗後對電路進行X射線檢查,其中10隻電路完成(chéng)了全部的1000次溫循試驗,其他電路由於要進行破壞性的鍵合拉力(lì)和芯片(piàn)剪切力試.驗,溫循次數依次遞減。X射線檢(jiǎn)測按照GJB
548B的相關要求進行,由於該(gāi)電路采用平行封焊工藝,因此在X射線檢測中僅針對芯片的空洞缺陷進行(háng)檢查。見(jiàn)圖3。
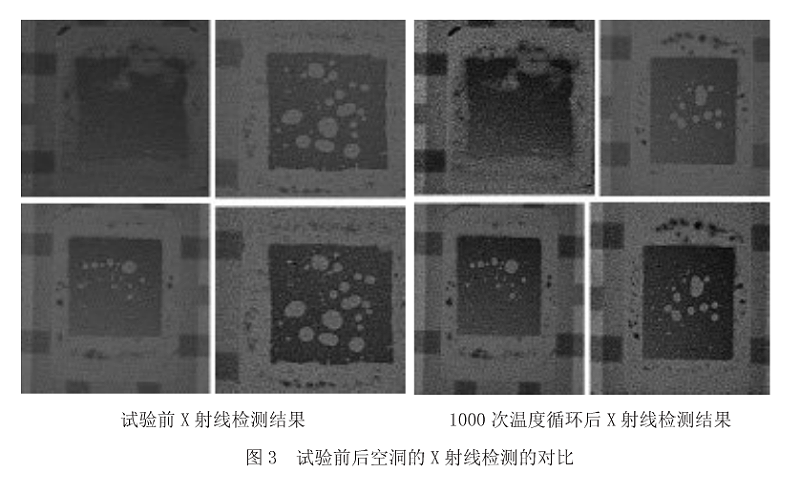
溫度(dù)循環試驗過程中由於封裝材料間的熱膨脹係數不一樣,在溫(wēn)度變化過程中(zhōng)材料間的接觸(chù)麵可以因熱膨脹係數(shù)的差異產(chǎn)生(shēng)剪切應力,當(dāng)剪(jiǎn)切應力作用試驗足夠長(zhǎng)、應力足夠大時,可以對產品的結(jié)構產生影響。溫度循環(huán)試驗可能造成芯片粘接空洞的擴大,造成產品芯片粘接強度的降低,影響產品的使用(yòng)可靠性。
從試驗前(qián)後X射線(xiàn)檢測圖片對比可以看到,該電路在1000次溫度循環試(shì)驗前後的空洞缺陷沒(méi)有出現擴(kuò)大(dà)、惡化(huà)的(de)情況,試驗前後的空洞麵積基本一(yī)致。參考(kǎo)芯片剪切強度測試結果,芯片(piàn)剪切強度未出(chū)現明顯的退化。說明(míng)在經過1000次溫度循(xún)環後,產品的結構和可靠(kào)性沒有出現異變,測試結(jié)果均滿足標準(zhǔn)的要求。
3、結論
溫度循(xún)環試驗造成了芯片粘接可靠性的(de)退化,並且具備累計效應(yīng),在溫(wēn)度劇烈變化時,會加快芯片粘接性能退化速度(dù)。但該結構電路(lù)的芯片、管殼(ké)、粘接材料間的熱匹配較好,抗溫度變化的性能較(jiào)高,在1000次溫度循環試驗後(hòu),沒(méi)有出現剪切強度不合格的情況,粘(zhān)接強度的退化比較輕微,在(zài)正常使用情況下可以保證長期的(de)粘接可靠性。
溫度循環試驗對(duì)引線拉力強度有一定的影響,溫度循環試驗(yàn)次數(shù)少的電路引線拉力強度(dù)優於溫度循環(huán)試驗次數多的電(diàn)路(lù)。在1000次溫度循環試驗中引線拉力強度至少出現了(le)一次拉力強度退化的過程,這個結果與GJB548B中試驗前合格拉力判別值高於試驗後合格拉力判別值的規定值相(xiàng)符合的。但(dàn)隨著溫度循環試驗(yàn)的持續進行(háng),引線拉(lā)力強度是否會出現二次退化,由於試驗次數的限製,不能(néng)進行進一步的驗證。
該封裝結構所使用的封裝材料間熱匹配比較(jiào)好,在經過1000次溫度循環試驗後,產品在(zài)結構和封裝可靠性方麵沒有出現不滿足標準的情況(kuàng),並且芯片粘接(jiē)空洞沒有出現明顯的(de)變化,在芯片粘接性能方麵還具有較高的可靠性。
文章選自網絡,如有侵(qīn)權,請與我司客服聯係,我們馬上刪除。