案例分析:基於溫度循環試驗判斷半導體(tǐ)分離器件不良現象
作者:
網絡
編輯:
草莓视频网站儀器(qì)
來源:
網絡
發布日(rì)期(qī): 2020.06.18
例1:待測器件經過(guò)1,000小時溫度循環試驗後測試結果顯(xiǎn)示電性為開路狀(zhuàng)態。通(tōng)過不良品分析(xī)實驗,剝離器件外部塑封膠後發(fā)現(xiàn)晶片與框架焊接過程中所(suǒ)使用銀漿在與晶片背麵的焊接區域出現斷裂狀態(圖1)。通常半導體器件焊接所使用(yòng)的銀(yín)漿的成(chéng)分為錫/銀/銅,晶片的基材為矽。焊接(jiē)過程(chéng)中焊接溫度的設定,銀(yín)漿(jiāng)量的控製,晶片(piàn)的柔片次數,塑封膠(jiāo)注人的壓力等都會對產品的終可靠性造成影響。當器件處於(yú)極端溫度變差及輸入偏壓開關模式(shì)下,器(qì)件在薄弱的不同介質結合(hé)麵會(huì)出現(xiàn)開路(lù)狀況,從而造成器件整(zhěng)體功(gōng)能或電路(lù)模塊的失效(xiào)。如果各種材料(liào)在高低溫下(xià)通過各自的膨脹係數所產生的應力沒有(yǒu)通過結合麵(miàn)之間的綬衝結構得到釋放,這種影(yǐng)響可(kě)能會通過(guò)銀漿的結合麵(miàn)將應(yīng)力傳導到器件(jiàn)為脆(cuì)弱(ruò)的晶片內部,造成芯片內部的物理(lǐ)損傷,隨(suí)著實驗(yàn)時間的集聚(jù),終造成電(diàn)性的不良,嚴重的情況下會顯示出晶片的斷裂或燒毀。
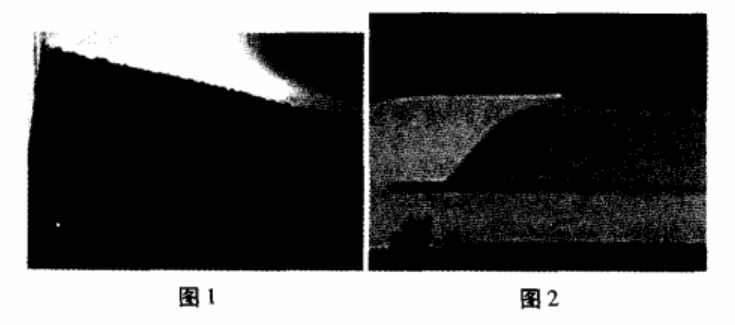
例(lì)2:待(dài)測器件在溫度循環試驗之後出現焊接銀漿重新(xīn)融化現象(圖2) ,在(zài)外力的擠壓下,銀(yín)漿流動到晶片表麵,造成器件短路。通常焊接用銀(yín)漿的熔點在(zài)260℃以上(shàng),銀漿(jiāng)在(zài)測試過程中的重新融化現象表明測試過程中晶片的結溫超出銀漿的融化所需(xū)溫度。理論上晶片的結溫(wēn)取決於外部環境(jìng)溫度和PN結本(běn)身在偏壓作用下的溫度升高。溫度循環(huán)試驗中環境溫度為125℃,當PN結在合理偏(piān)壓的設定條件下器件的結溫不會超出器件的允許結溫設定,一般為150℃或175℃ ,不會出現銀漿(jiāng)重融現象。因為焊(hàn)接用銀漿和器件框架(jià)均包含金屬成分,其(qí)散熱性能良好,在正(zhèng)常情(qíng)況下可以將晶片的結溫(wēn)通過銀漿、框架有效傳導到器(qì)件外部消除結溫過高對(duì)晶片的損害。
通常的問題出在(zài)銀漿焊接過程中流動性不好造成晶片底部銀漿空洞,當結溫急(jí)劇(jù)升高時,空洞(dòng)中的空氣無法將結溫通過銀漿有效傳導出(chū)器(qì)件外,造成晶片局部;溫度過高(gāo)出現熱點,導致銀漿的融化。這種現象要求在銀漿焊接的工藝製程中有(yǒu)效控製每顆材料焊接(jiē)過程中的單個空洞麵(miàn)積和銀漿總體有(yǒu)效焊接麵積,避免PN結溫度傳遞中的問題。同樣對於器(qì)件熱阻較高的產品,當環境溫度升高時由於熱阻的迅速升高,可能遠遠超出產品設計規格,器(qì)件的結溫(wēn)會迅(xùn)速躥升超出允許結溫,此時過高的溫度會造成(chéng)銀漿的重新融化,這要求在晶片的設計過程中通過工藝(yì)的改進,減(jiǎn)少熱阻的影響,從而同(tóng)時提高產品的工作效率。
從以(yǐ)上實例分析中可以看到溫度循環測試對於半導體分(fèn)離器件在內部不(bú)同介(jiè)質(zhì)界麵的可靠性測試中充分反映出(chū)潛在需要提高的問題,為產品的終應用提供有效的評估方法。