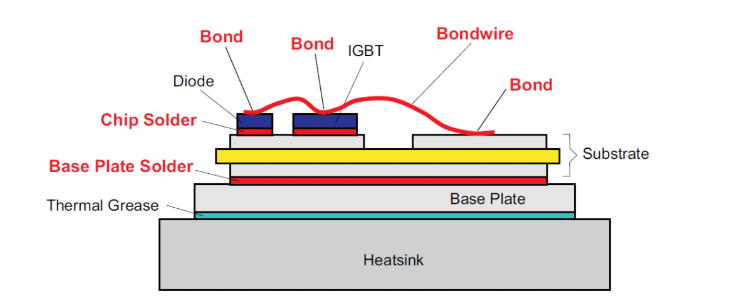
圖:IGBT模塊的結構細節
由於功(gōng)率循環中,矽芯片的熱機械失配較大,因此功率循環會在矽(guī)芯片的金屬層上引起重要的周期性壓縮應力和拉伸應力。結果,這種應力(lì)可能遠遠超過(guò)彈(dàn)性極限(xiàn),並且它們的變(biàn)鬆可能通過機械過程(chéng)發生,例如通過(guò)擴散蠕變(biàn),晶界滑動或位錯滑行引起的塑性變形等。這可能會導致鋁晶粒(lì)的擠出,也可能(néng)會導致晶粒邊界處的氣(qì)穴效應,也即是空洞的形成(chéng),具體(tǐ)取決於金屬化的質(zhì)地,這導致芯片(piàn)表麵鋁的重新構造,並導致其薄層電阻隨時間增加。這可以通過測量IGBT導通狀態下的壓降來對其進行監視。大的電流幅(fú)度會加速此過程。芯片金屬層的變化逐漸增加了芯片電阻,從而導致額外的損耗(hào)、更高的結溫變化和鍵合線的粘(zhān)附性更(gèng)差,從而加速了失(shī)效的過程。

與銅材料和矽芯片相比,鋁線具(jù)有相對較高的熱膨脹係數,在高(gāo)額定電流和開(kāi)關操(cāo)作的(de)工作(zuò)條件下(xià),IGBT的引線鍵(jiàn)合(hé)幾乎暴露於由(yóu)矽芯片中的功(gōng)耗(hào)和引(yǐn)線鍵合本身所造成的整(zhěng)個溫度波動。此外,由於集膚效應,整個截麵上的電流密度分布非常不(bú)均勻。通常,引線(xiàn)鍵合的失效主要是由於(yú)在焊盤和引線鍵合之間(jiān)產生(shēng)的剪切(qiē)應力引起(qǐ)的疲勞而導致的(de)。結果,它們逐漸與IGBT芯片斷開,直到它們達到(dào)損壞/開路狀態。可以觀察到兩種現象(xiàng):焊線根部的裂紋擴展,即Heel Crack;或者焊線(xiàn)的剝離,即(jí)Wire bonding lift-off。對於上一種情況,此問題來自沒有優化的引線鍵合工藝,該工藝會機械地損壞引線鍵合根部,造(zào)成產生裂紋(wén)。在後者中,引線鍵合(hé)會老化,由於材料之間(jiān)較高的熱膨脹係數(Coefficient of Thermal Expansion)的不匹配(pèi)而導致其剝離。這種(zhǒng)破壞始於引(yǐn)線鍵合尾部的裂紋,並通過引線(xiàn)鍵合和芯片上金屬之(zhī)間的界(jiè)麵傳播(bō),直到完全剝(bāo)離為止。可以通過測量接觸電(diàn)阻或電流(liú)內部分布的變化從外部檢測失效的發展,從而可以通過監測導(dǎo)通狀態下的器件(jiàn)壓降(jiàng)來跟蹤(zōng)失效的發展。在IGBT模塊中柔軟的(de)矽樹脂可以吸收這些機械(xiè)振動。由於每個芯片的額定電流>10A的IGBT模塊具有多條並聯(lián)的焊線,因此,失去焊線接觸不會(huì)立即導致器件(jiàn)失效。那些平行的,尚未完全破壞的鍵合線現在必須承載額外的電流,引線鍵合的焊腳將被加熱(rè)得更多。因此,它們的老化過程被進一步(bù)加速。在剩下的後一個鍵合線中,電流密度將會很高,以至於芯片(piàn)的金(jīn)屬層將開始熔化(huà),會產生內部電弧,並破壞芯片。
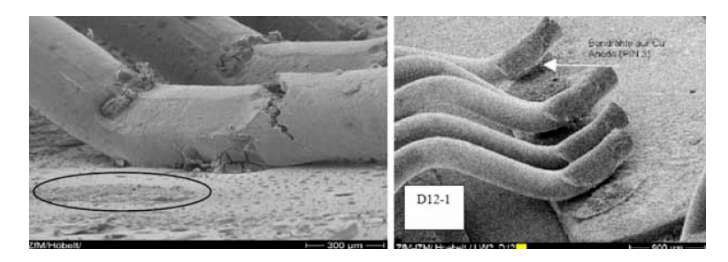
IGBT的一個主要失(shī)效機理與焊接層(céng)的熱-機械疲勞有關。關鍵的交(jiāo)界麵是芯片連接陶瓷基板的Die Attach層和陶瓷基板與金屬底板之間的焊接層。在這樣的位(wèi)置,通常可以發現(xiàn)在(zài)兩個界麵上的熱(rè)膨脹係數(Coefficient of Thermal Expansion)失配嚴重、並具有大的(de)溫度擺幅;並且對於陶瓷基板與金屬底板接觸來說,具有大的(de)橫向尺寸。IGBT模塊中用作焊接層的常用材料是(shì)錫銀,銦或(huò)錫鉛合金。它們具(jù)有出色的電性能,並且作為軟焊料,它(tā)們具有(yǒu)良好的流動特性。通常,焊(hàn)接層被視為一個單一的均(jun1)相,但(dàn)事實並非如此,因為它(tā)們的相(xiàng)會隨著時(shí)間而發生變化。例如,當將具有銅金屬鍍層的陶瓷基板與標準鉛錫合金焊接在一起時,主要通過形成(chéng)靠(kào)近銅層的Cu5Sn6合金層相來提供鍵合。在焊接層的部分形成了另外兩(liǎng)個不同的相,一個富錫和一個富鉛。在加速老化測試中,由(yóu)於合金在較高的同源溫度下工作,這些相迅速變粗,從而改變了其熱機械性能;由於銅相比錫鉛相脆得多,因此熱機械疲(pí)勞(láo)裂紋常在富銅合金層間傳播(bō)。由於較大的熱膨脹(zhàng)係(xì)數(Coefficient of Thermal Expansion)失配和(hé)較高的溫度(dù),先在緊接(jiē)在陶瓷基(jī)板下方的合金層附近發(fā)現疲勞裂紋。金相學研究表明,裂紋在焊接層的邊界處開始,該處(chù)的切應力達到大。另外,在陶瓷基板的(de)邊緣處銳角的存在極大地促進了(le)裂(liè)紋的形成。以上的過程,將(jiāng)會導致模塊的熱阻增加,這(zhè)會導致IGBT的芯片過熱,並加快其它失(shī)效的速度,以至於它(tā)們隨後會產生失效。盡管大(dà)的接(jiē)觸麵積是金屬底板和陶(táo)瓷基板背麵金屬化層之間的焊接層,從九十年代末開始,可使用相對堅硬的、並(bìng)具有接近陶瓷(cí)基板的CTE(如AlSiC材料)代替銅作為基板材料,在該區域產生熱-機械應力可以大大減少。
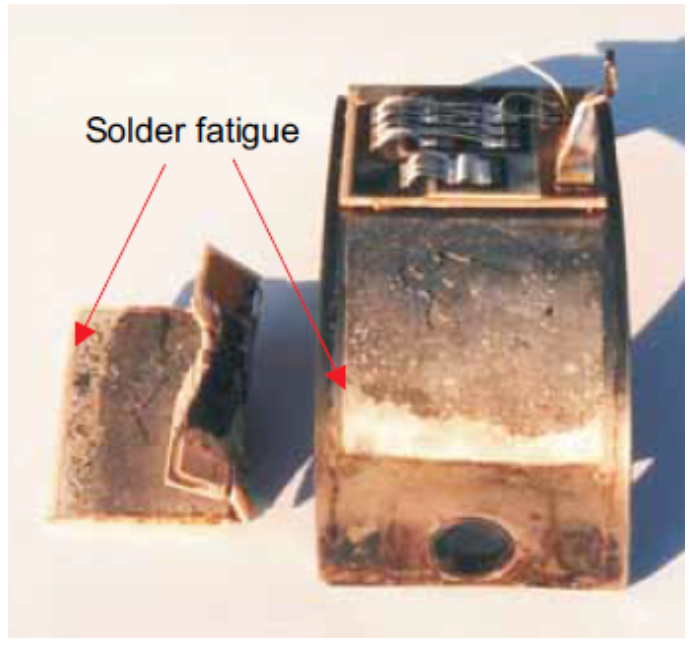
功率循環測試後,在陶瓷基板邊緣處可以觀察到較大麵積的(de)分層。邊緣處的不連續導致該位置,特別是邊角處的應力峰值。這是由於這樣的事實:粘結的材料可以沿(yán)無限製(zhì)的方向隨溫(wēn)度自由膨脹,但(dàn)是,在材料粘結的界麵(miàn)處,它們是粘合的,並且它們的熱-機械(xiè)特性,主要是楊氏模量和熱膨脹係(xì)數將限定器件封裝的形變。因此,對於較高/較低的楊氏模量以及非常不同的(de)熱膨脹係數和(hé)材料厚度,預期將獲得更多的局部的/分散的應變,其接近器件封裝邊緣處的不連續性,終將導致較高(gāo)和局部的應力/較低且分布更廣的應力。因(yīn)此,斷裂(liè)始於外角和邊緣,並向焊接(jiē)材料的中擴散,從而吸收了這種存儲的機械能。當一個IGBT模塊表(biǎo)現出溫度不均勻並(bìng)且存在高溫(wēn)梯度時,焊接層的劣化(huà)從指向達到較高溫度的模塊位置的邊角(jiǎo)開始並(bìng)向外移動。IGBT模塊Die Attach層的疲(pí)勞,大多與鍵合(hé)線的損壞一起出現(xiàn)。整個IGBT模(mó)塊加熱(rè)得越多,焊料連接所受的應(yīng)力就越(yuè)大。焊接疲勞會導(dǎo)致Rth和芯片溫(wēn)度升高,進而會導致更高的損耗,從而導致IGBT中的結溫更高。加速了被測IGBT器件的老化(huà)過程。
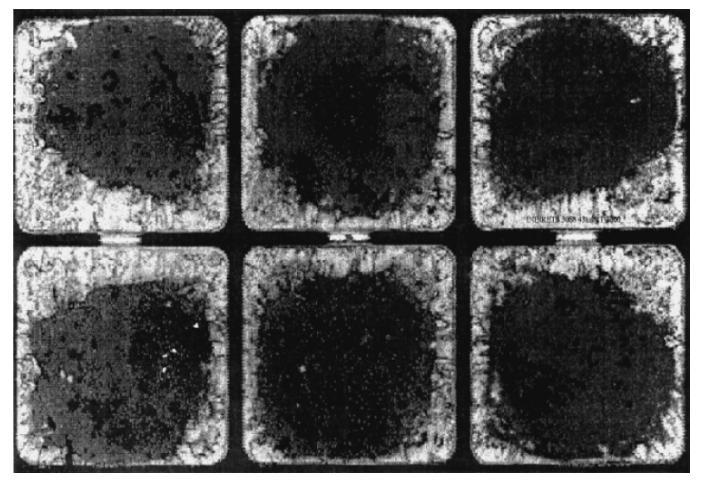
SAM顯示的焊(hàn)接(jiē)層分層
作者:王剛
文章選(xuǎn)自(zì):數字化工業軟件技術期刊
如有侵(qīn)權,請告知草莓视频网站儀器客服,我(wǒ)們立馬刪除
400電話